2. Theory
3. Method of TE
4. Summary
5. Ideas
Lower coefficient of performance than vapor-compression systems.
Relegated to low heat flux applications.
More total heat to remove than without a TEC.
▪ Mini contact : TEC – Silicon Chip
▪ Concentrating the TEC Power on a Small Area
▪ TEC with 20μm-thick Bi2Te3
▪ 10W
▪ 1250μm x 1250μm Copper Mini-contact Pad
Based on the use of SiGe/Si superlattice structures attached to silicon substrates, have received increasing attention for hot spot thermal management because these solid-state devices are compact, light weight, have no moving parts, and are capable of providing localized, high-flux, on-chip active cooling.
Table I provides the thermal and electrical properties for three typical thermoelectric materials, Bi2Te3, SiGe, and single-crystal silicon, at room temperature
The only different between passive and active solid-state cooling is the utilization of a thermoelectric module (TEM) sandwiched between the processor and the passive or active heat sink.
• Thermal Design Power(TDP) is method of cooling for chip, but it
reflects the uneven power distribution, and also may result in over
Cooling of large areas, leading to excessive package cost.
• Active cooling technologies have shed new light on this matter.
And Thermoelectric cooler(TEC) has been the most accessible one.
Not discrete, thick bulk materials.
• Some of literature describe about thin-film TEC
Venkatasubramanian et al.
Bottner et al.
Snyder et al.
Chowdhury et al.
Mini-Contact Enhanced Thermoelectric Cooling of Hot Spots in High
Power Devices
- Analytical modeling of silicon thermoelectric microcooler
- A Framework for Optimizing Thermoelectric Active Cooling Systems
- Experimental Analysis Model of an Active Cooling Method
for 3D-ICs Utilizing a Multidimensional Configured Thermoelectric
- Thermal Management of On-Chip Hot Spots and 3D Chip Stacks
- Hot Spot Cooling using Embedded Thermoelectric Coolers











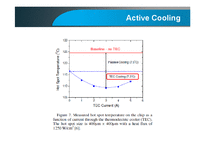


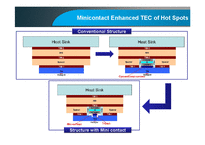
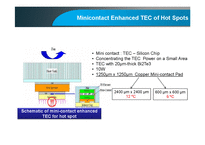

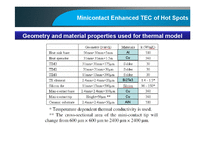
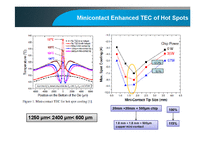
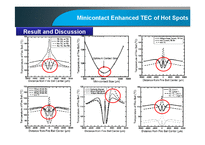

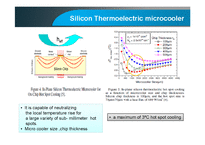
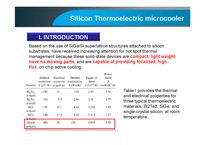
 분야
분야


